磁控溅射制备Al2O3薄膜
发布时间:2020-08-08
磁控溅射镀膜技术与其它镀膜技术相比具有沉积温度低、溅射速率快的优点,在科研领域受到高度关注。
溅射是指真空中带有能量的入射离子撞击靶材表面,靶材表面原子获得能量从靶材表面脱离的现象。如图所示,带电离子Ar+轰击Al靶表面,Al靶表面的Al原子不会直接脱离靶面,被撞击的Al原子能量会传递给临近的Al原子,从而引起Al靶面点阵连锁式的碰撞,点阵排列中的Al原子受到周围Al原子能量的传递,当Al原子能量聚集超过原子间结合能时,Al原子就会从Al靶表面逸出,溅射发生,溅射出的Al原子与O2反应形成Al2O3薄膜沉积在基底上。

(1)直流溅射
直流溅射时靶材为阴极,电源为直流电源,电荷会不断累计,所以直流磁控溅射的靶材适用于金属材料和导体材料,不适用于绝缘材料。以绝缘材料为直流溅射靶材,靶面受离子轰击,大量正电荷聚集于靶表面,靶材由于作为阴极建立的负偏压减弱,同时电场强度也因靶表面电位增加而降低,入射离子因能量不足无法溅射。
溅射过程中,需不断提高放电电压,基底不断受到高能粒子的轰击,容易损伤沉积薄膜并引起基底温度升高。当沉积金属薄膜时,如果入射Ar+轰击正在沉积的薄膜,沉积的薄膜吸收入射Ar+的能量,将会导致沉积薄膜的晶格结构发生生长或收缩。当工作气压较低(<0.1Pa)时,Ar难电离,无法维持溅射;工作气压较高(>3.0Pa)时,沉积的薄膜质量较低。因此选定溅射气压0.1Pa~3.0Pa来进行反应,此时能够持续放电,使二次电子产生足够的能量离化溅射离子。
直流磁控溅射Al2O3薄膜时一般采用高纯Al靶为溅射靶材,通入O2和Ar进行反应溅射。如图所示,电子e在电场E作用下飞向基底,电子e运动过程中与Ar产生碰撞,Ar被电离产生Ar+和新的电子e,Ar+在电场E作用下加速飞向阴极Al 靶,进而对Al靶进行轰击。碰撞产生的二次电子在磁场B和电场E的共同作用下形成一条类似于摆线的运动轨迹。磁场形状为环形,电子在磁场B作用下在Al靶周围产生环形运动轨迹,且只能在Al靶周围的等离子体区域运动,同时在该区域Ar的电离程度增大,电离产生大量Ar+轰击Al靶表面,Al原子溅射率增加,Al原子与O2进行反应沉积到基底上形成Al2O3薄膜,Al2O3薄膜的沉积速率增加。二次电子e在电场E的作用下运动至基底上,由于电子e在Al靶周围等离子区域的运动过程中不断碰撞,能量消耗较大,所以到达基底上的能量较弱,基底温升较低。所以直流磁控溅射Al2O3薄膜具有沉积速率快、沉积温度低等优势。

(2)射频溅射
射频磁控溅射是在靶材阴极上加载高频电压,等离子体区域中的离子和电子将会在高频电场的驱动下向靶面移动,离子的运动速率较电子运动速率高,所以离子向靶材阴极的移动跟不上靶材阴极高频信号的变化。在正半周期内将有大量电子运动至靶材表面,靶面带有负的自偏压,负偏压加载在电磁场中,离子得以加速运动,溅射现象产生。磁控溅射多元成分的合金或化合物薄膜时,调节溅射工艺参数能够改变薄膜的性能质量,但是直流磁控溅射介质薄膜时会出现靶中毒现象,溅射不稳定。当采用射频溅射绝缘层薄膜时靶中毒现象就不会发生。
Al靶处于电源负半周期,Ar+对Al 靶进行轰击,如(a)所示;同时,能量损失殆尽的Ar+沉积在Al靶表面,如图 2.3(b)所示;当Al靶处于电源正半周期时,靶面的Ar+与轰击Al靶表面的电子e抵消,如图(c)所示。在射频电源的一个周期内电子e和Ar+轮流轰击Al靶表面,Al靶受到轰击的时间和电压都会增加,Al2O3薄膜被连续不断的沉积出来。射频电源与沉积在Al靶阴极表面的Ar+进行中和,靶面电位被降低。阴极靶又为永磁靶,即在阴极靶的内侧装有永磁铁建立磁场来限制电子的运动区域和轨迹,使电子沿着Al靶做周期性运动来加大与Ar的碰撞程度,Al靶与Al2O3靶射频沉积Al2O3薄膜相比,Al靶射频沉积Al2O3薄膜中Al元素充足且效率高。
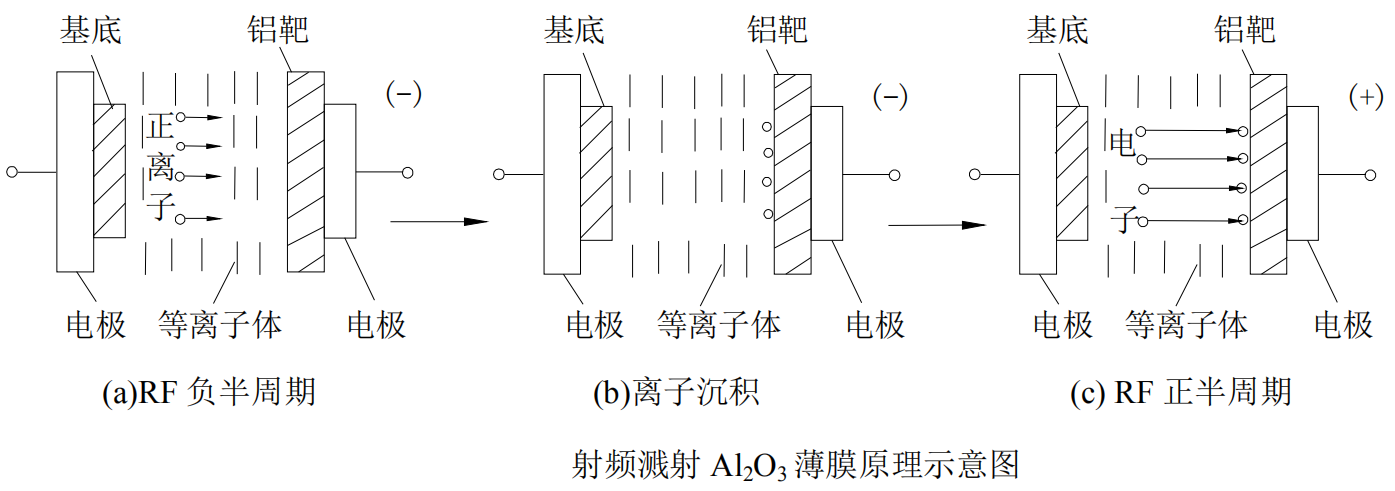
内容摘自《直流、射频磁控溅射制备Al2O3薄膜工艺探索及其性能的研究》
